您可以访问哪些超高密度互连PCB能力?

当我们谈论封装、类似基板的PCB以及细线PCB时,我们实际上是在提到一个PCB制造加工正推向极限的领域。这个领域是超高密度互连(Ultra-HDI),典型的PCB特征被缩小到非常小的值。这些更高级的能力使得传统的设计实践能够应用于更大的BGA,但是缩小到非常细的间距(0.3 mm),需要紧密的间距和线宽。
这些能力在历史上在亚洲可用,以前它们只有在大量生产时才真正具有成本效益。现在,全球对这些高级能力的获取正在扩大,更多的设计师可以在较低的量产,甚至在原型设计期间访问这些能力。这也意呀着,在较低的量产中可以使用更多在高量产的消费设备中找到的高级组件。
超高密度互连推动制造能力的极限
超高密度互连(Ultra-HDI)并不是设计PCB的新方法。无论减法或加法,已经被用于非常密集的PCB(例如在智能手机中)和IC封装(在基板和RDL中)。这种能力通常只有在非常高的体积时才具有成本效益,这就是为什么它能够支持一些最高计算能力的消费产品和具有更高I/O计数的IC生产。现在,随着低体积制造商的出现,这种能力变得更加可获取。
下表列出了一些通常与超高密度互连(ultra-HDI)相关的制造特性。这些值是从两个提供这些能力的美国制造商那里编译而来的。下面列出的特性限制并不全面;不同的制造商将提供不同的关于他们的超高密度互连制造能力的保证。
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
|
上述几项能力中的一些是标准HDI板的典型特征,而其他一些则超出了IPC-2226(C级)当前定义的标准化。例如,在这些板中,通孔via的尺寸限制与标准HDI相同。然而,线宽限制要小得多,降至0.6mil。根据线宽,可能可以进行蚀刻,但最终可能需要使用添加剂过程(例如,SAP、mSAP或A-SAP)。
您可以用超高密度互连(Ultra-HDI)做什么?
因为超高密度互连将特征尺寸推向低限,这种方法使得两种设计优势成为可能:
- HDI板中的层次减少 - 细线路可以实现迹线的合并到更小的层次数,这减少了HDI构建层的数量。
- 常规构建中的小线宽 - 如果您能完全消除HDI构建,您可以大大减少制造PCB所需的成本。
如果您能减少HDI堆叠层数,就可以抵消一些访问超高密度互连(ultra-HDI)制造能力所需的额外成本。
示例1:赛灵思 FPGA(0.8 mm BGA)
BGA通常是推动HDI制造的因素,因为需要为这些大封装创建扇出。这通常是通过堆叠的盲埋机械钻孔完成的。在1 mm的间距下,您通常可以使用直径为8或10 mils的通孔,这取决于焊盘/球尺寸。由于间距和线宽限制,您可能只能在每层之间放置单条走线。
有了超高密度互连能力,您现在可以在焊盘之间放置两条相当宽的走线。根据引脚排列,这可能允许减少层数,因为您可以将走线合并到更少的层数中。下面的图片显示了DDR接口中的几条走线,其中走线宽度=2.25,S/W=1.5。

以这种方式使走线更靠近会增加串扰,但我们可以通过使用更薄的介电层(走线到GND的距离更小)来克服这一点。
因为串扰水平与层厚度的关系是非线性的,更薄的层将使您能够达到阻抗目标,并允许更密集的布线而不会带来巨大的串扰损失。这通常意味着在这些密集的板上,尤其是在考虑阻抗时,需要更薄的层。
如果我们更加激进,采用更细的走线宽度,保持相同的S/W比例会怎样呢?在下面的图片中,我将走线宽度减小到1 mil;保持相同的S/W比例,我们现在可以在这个BGA中的垫之间打包4条走线。然而,由于串扰的挑战和DDR接口中的阻抗要求,设计将需要一个更薄的层来确保达到走线阻抗要求。

通过将BGA焊盘间的走线数量加倍或增加四倍,我们可以减少完成BGA展开所需的层数。在较小的间距(0.5 mm至0.8 mm)中,这通常需要盲埋孔和焊盘间更精细的布线,我们可以减少HDI建层的数量,这将显著减少加工步骤的数量,并有助于控制制造成本。甚至可能将HDI构建转换为常规构建,这可能会抵消精细线路制造的成本。
示例2:nRF52 WLCSP(0.35 mm BGA)
在非常细的间距组件中,传统方法是使用盲埋孔并在每层的焊盘下方布线。由于BGA中球与球之间的间隙要求,使用传统能力根本没有空间在焊盘间布线。超高密度互连(Ultra-HDI)通过允许更小的孔径和更薄的走线,改变了这一点,因此可用的布线区域受到焊盘大小的限制。
下面的布线示例展示了我们之前的nRF52模块项目,但在BGA展开中重新设计了焊盘间的精细线路布线。在在这个项目的原始版本中,电路板采用了2 + N + 2堆叠在6层上设计。凭借超高密度互连(HDI)能力,我能够在单层上实现焊盘间的布线。这里我展示了同一图像中的两个例子:
- 1.75 mil的走线宽度与1.75 mil的焊盘间距
- 1 mil的走线与1 mil的间距(走线到焊盘和走线到走线)

有了这种BGA间距,我可以在两个焊盘之间舒适地布置1.75 mil的走线/间距,或者我可以更激进地在两个焊盘之间布置两条1 mil的走线。第一种情况是更好的选择,因为在2倍布线中走线之间的串扰更大。
显然,2倍走线之间的间距小于3W规则限制。我们能违反这个限制并仍然期望合理的串扰吗?答案是“也许”... 我在其他文章中展示过,并且信号完整性(SI)工程师们都知道,将地线靠近一对走线可以减少它们之间的互相电容和互感。因此,采用这种更激进的布线需要使用更薄的层。这是因为:
- 更接近的地面区域减少了给定层厚度的串扰
- 对于阻抗控制线路,较薄的层允许达到典型的阻抗目标
这就是为什么在这种非常精细的间距中,2x走线可能不是最佳选择,因为这些走线之间可能存在潜在的串扰。更好的选择是1.75 mil走线,如果这是在较厚的层上完成的(约3 mil),那么任何阻抗控制的走线仍然可以达到50欧姆的目标。
超高密度互连(UHDI)材料
在上述讨论中,我深入探讨了UHDI板所需的材料。这样做有两个与信号完整性相关的原因:紧密排列的走线之间的串扰,以及使用窄线宽达到阻抗目标。
为了实现这些目标,需要使用非常薄的走线和薄层计数。通常在各种可能的材料中应用最多50微米的上限,例如Happy Holden列出的11种HDI材料中所列出的。一些常见的替代材料包括激光钻孔材料和薄的增强型FR4,例如:
- 味之素构建膜(ABF)
- 基于BT环氧的材料
- 薄液晶聚合物(例如,UltraLam)
- 树脂涂覆铜膜(金属化聚酰亚胺、纯聚酰亚胺、铸造聚酰亚胺)
这些材料可以组合使用,创建超高密度互连(HDI)构建。其中一种组合是使用BT环氧基层压板作为核心,配合传统的埋藏式通孔,并使用ABF作为外部构建层,支持细线路布线。这种构建风格被用作BGA封装的有机基板,但同样的方法也可以用于超高密度互连的PCB。下面展示了这种构建的示例。
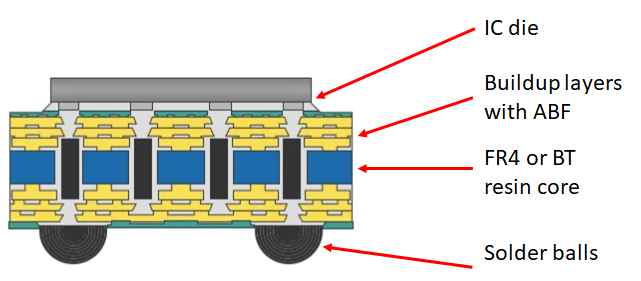
成本更高,但选择更多
虽然这些更高级的设计实践带来了更高的制造成本,并且它们需要一种新的堆叠设计和布线方法,但你可以为你的PCB使用更高级的、具有更细的间距的组件。总体而言,细线路制造可以减少为了配合这些更细的间距而需要的HDI构建层数,通过在细间距BGA上的球之间实现布线。
在某些情况下,超高密度互连(ultra-HDI)可以通过层合并和转换为常规的机械钻孔通孔构建来大幅降低成本。如果你能在8层的BGA上的垫之间放置4倍的走线,那么如果你无法使用超高密度互连技术,同样的板可能需要32层。如果你对这些能力感兴趣,它们刚开始在美国和加拿大变得可用,并且在欧洲和日本仍然可以访问。
每当你需要设计一个超高密度互连的PCB时,确保你使用了Altium Designer®中完整的PCB设计功能集和世界级的CAD工具。为了在当今的跨学科环境中实现协作,创新公司正在使用Altium 365™平台来轻松共享设计数据并将项目投入生产。
我们只是初步探索了在Altium 365上使用Altium Designer的可能性。今天就开始你的Altium Designer + Altium 365免费试用。






 Back
Back